在半导体工业中的应用
半导体行业高速发展需要实现更小的间距、更薄的基板、高质量的芯片键合。 激光辅助键合技术(LAB)适用于对速度、精度、局部甚至极小区域的精确加热控制有高度需求的半导体先进封装。相对于传统的回流焊、TCB,激光辅助键合不需要额外的措施避免热膨胀。在键合温度、作业时间、热影响区大小等方面具有明显的优势,是高精密芯片直接键合的最佳选择。
我们的产品LBS-M激光系统就采用了这一技术,它具备的技术优点使其成为大多数半导体应用的理想解决方案。
激光辅助键合也广泛应用于模具连接工艺中:
- 用于倒装芯片的激光回流焊
- 使用共晶预型件进行激光焊接
- 使用焊膏的激光焊接
- 激光压焊
- 激光基底加热器
- 用于焊线的激光基底加热器

激光辅助键合(LAB)工艺流程
芯片贴装和激光回流焊分为两个工位进行,UPH 相匹配,与 TCB 相比,吞吐量提高了 5 – 8 倍。
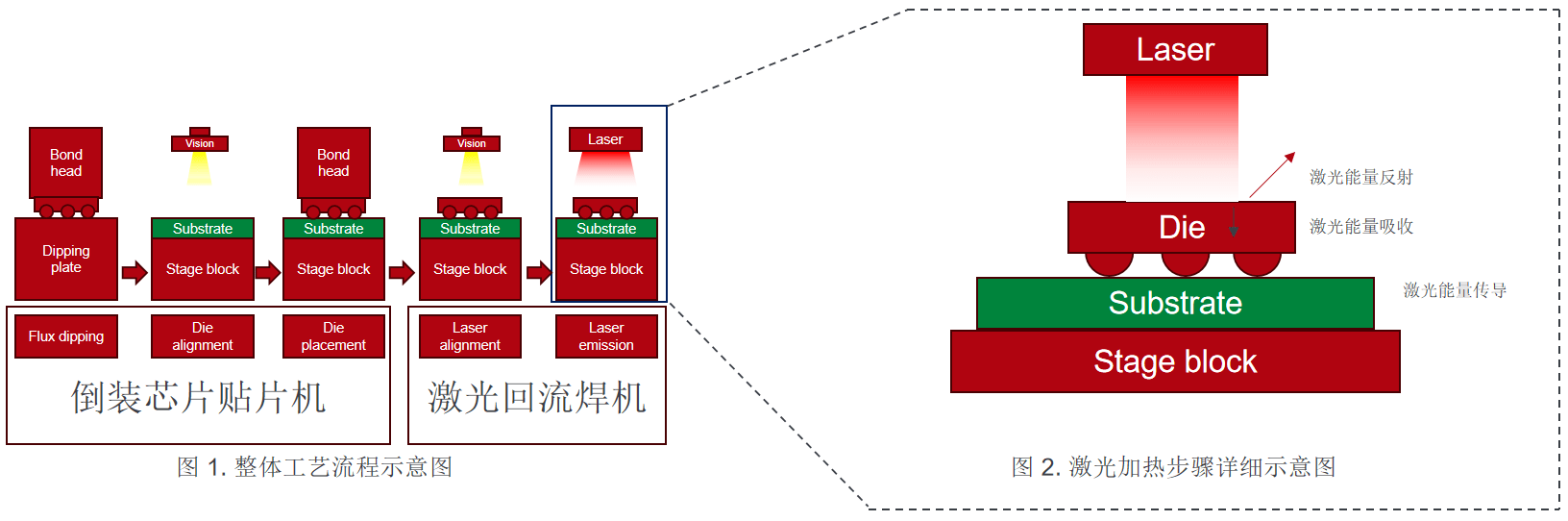
与 TCB(热压粘接)相比,LAB 具有以下优势
| 减少能源投入 | 更快的流程 | 更高的质量 | |
| LAB |
|
|
|
| TCB |
|
|
|
激光压缩键合(LCB)
激光压缩键合(Laser Compression Bonding, LCB)是一种结合激光技术和热压键合的先进封装技术。激光压缩键合设备包括传送单元、键合头等组成部分;键合头包含一个用于施加压力的键合工具、激光束发生器、热成像相机以及控制压力和位置的压缩单元;激光束发生器用于在键合过程中提供精确的温度控制,而热成像相机则用于测量半导体芯片和基板的温度。
激光压缩键合技术主要用于半导体芯片的封装,其优势包括:
- 精确的温度控制:激光束可以提供局部加热,确保键合区域的温度均匀且精确。
- 高效生产:通过激光辅助,可以加快键合过程,提高生产效率。
- 高质量键合:激光压缩键合能够提供更好的表面处理和更均匀的压力分布,从而提高键合质量。
与传统的热压键合相比,激光压缩键合在温度控制上更为精确,能够减少氧化和污染的风险,从而提高键合的可靠性和质量。
| 利用真空工具控制翘曲 | 焊接高度控制 | 快速升温 | 快速降温 | |
| LCB | √ | √ | √ | √ |
| TCB | √ | √ | √ | × |
 DYNALAS
DYNALAS